高集成半导体用高密度封装基板
用于将高度集成的半导体芯片与主板连接的高密度封装基板。将半导体芯片与封装基板用 Flip Chip Bump连接起来,要求基板电路的微细化和高多层需要的层间微细匹配,特别是为应对 High Performance Computing,需要 Large Body Size、高多层 (~110×110㎜, 26L) 技术。
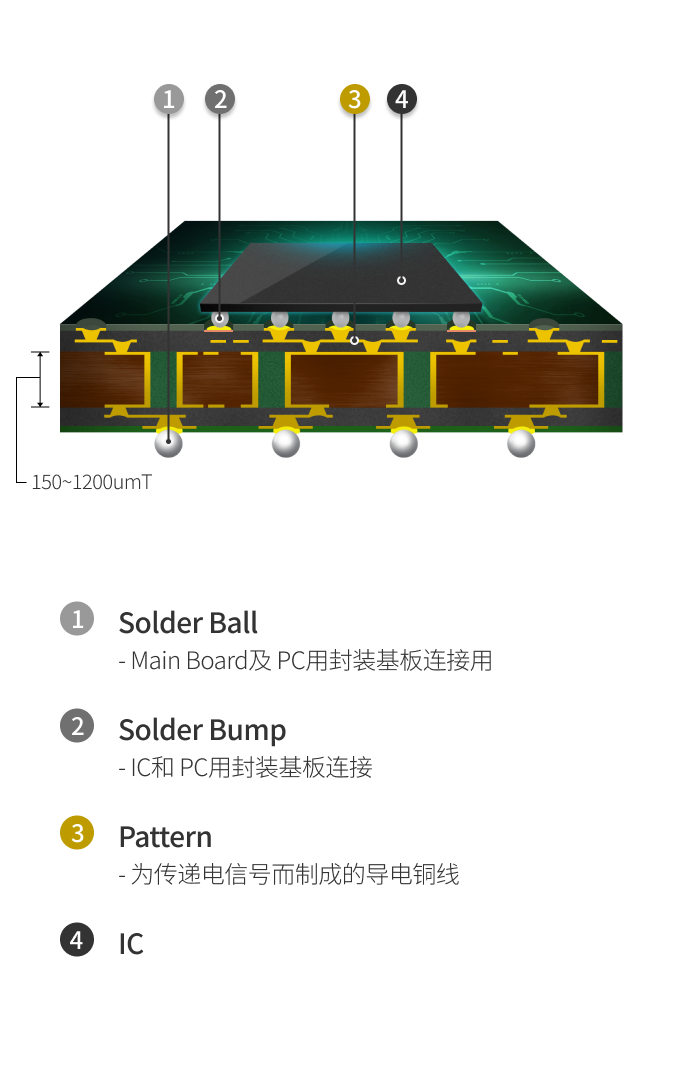
FCBGA Lineup
FCB有 Standard Core、Thin Core产品。
| Core Thickness (um) | Line Width / Space Bump Pitch (Mass Volume) |
Layer Counts | ||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|
| 4L | 6L | 8L | 10L | 12L | 14L | 16L | 18L | 20L | 22L | |||
| Standard Core | 1200 | 9 / 12um 90um |
Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Sample Available |
| 800 | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Sample Available | ||
| 600 | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | ||||
| 400 | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Sample Available | ||||||
| Thin Core | 250 | 9 / 12um 100um |
Mass Production | Mass Production | Mass Production | Mass Production | Sample Available | |||||
| 200 | Mass Production | Mass Production | Mass Production | Sample Available | ||||||||
| 150 | Mass Production | Mass Production | Sample Available | |||||||||
* um是指㎛。