High-Density Package Substrates for High-Integration Semiconductors
A high-density package substrate for connecting high-integration semiconductor chips to the main board. The semiconductor chip and the package substrate are connected with Flip Chip bumps, and fine matching between layers is required due to the miniaturization of the circuits on the substrate and the high multilayer. In particular, large body size and high multilayer (~110x110㎜, 26L) technology is required to support high performance computing.
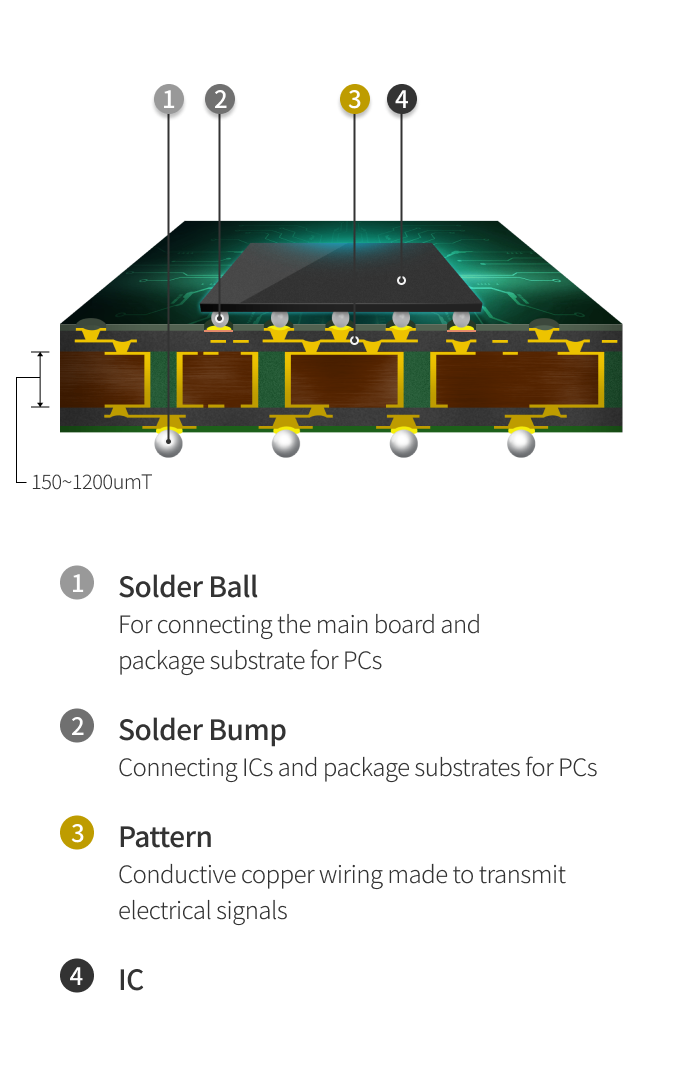
FCBGA Lineup
FCB is available in Standard Core, Thin Core type products.
| Core Thickness (um) | Line Width / Space Bump Pitch (Mass Volume) |
Layer Counts | ||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|
| 4L | 6L | 8L | 10L | 12L | 14L | 16L | 18L | 20L | 22L | |||
| Standard Core | 1200 | 9 / 12um 90um |
Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Sample Available |
| 800 | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Sample Available | ||
| 600 | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | ||||
| 400 | Mass Production | Mass Production | Mass Production | Mass Production | Mass Production | Sample Available | ||||||
| Thin Core | 250 | 9 / 12um 100um |
Mass Production | Mass Production | Mass Production | Mass Production | Sample Available | |||||
| 200 | Mass Production | Mass Production | Mass Production | Sample Available | ||||||||
| 150 | Mass Production | Mass Production | Sample Available | |||||||||
* um stands for ㎛