Package Substrate for System Implementation
It is a product that realizes complex functions as one system by mounting multiple ICs and passive components in a package. It is also used in products such as PA (Power Amplifier) and has heat dissipation characteristics. Product series include Flip-Chip SiP and Coreless.
Miniaturization
Multiple ICs and passive components are integrated into a single module to enable package miniaturization.
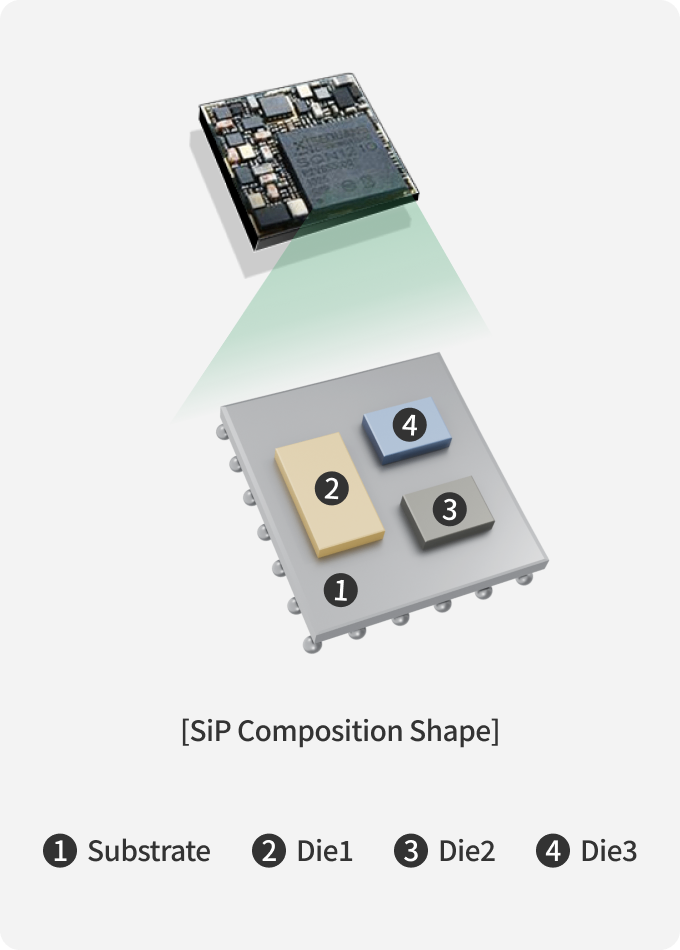
Thin Substrate
Can realize 0.2mm thin substrate (based on a 6-layer substrate) by securing the driving capability of ultrathin sheets.
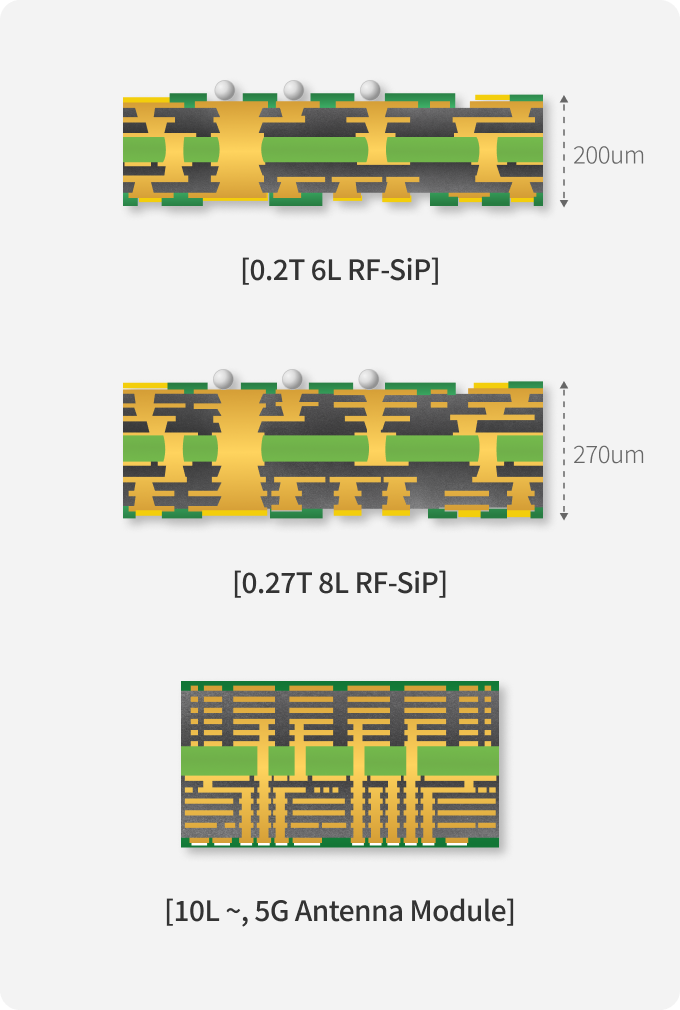
Main Core Technology
Coreless RF-SiP
The coreless method reduces the insulation thickness to improve signal characteristics by controlling Electro Magnetic Interference (EMI) and Parasitic Inductance, enabling the realization of thin substrates.
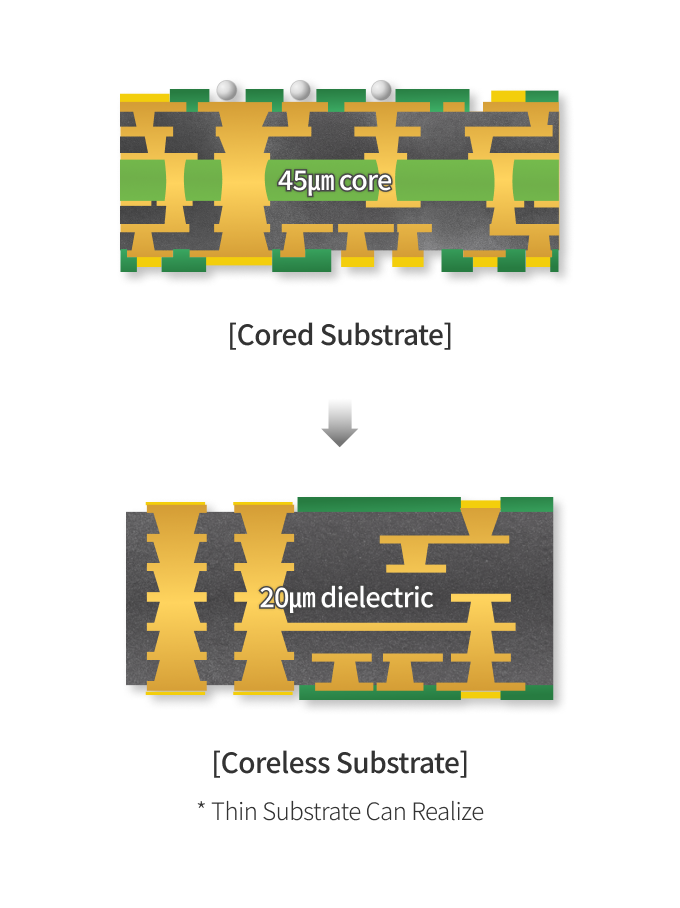
ENEPIG Surface Treatment
The ENEPIG surface treatment technology has the following characteristics.
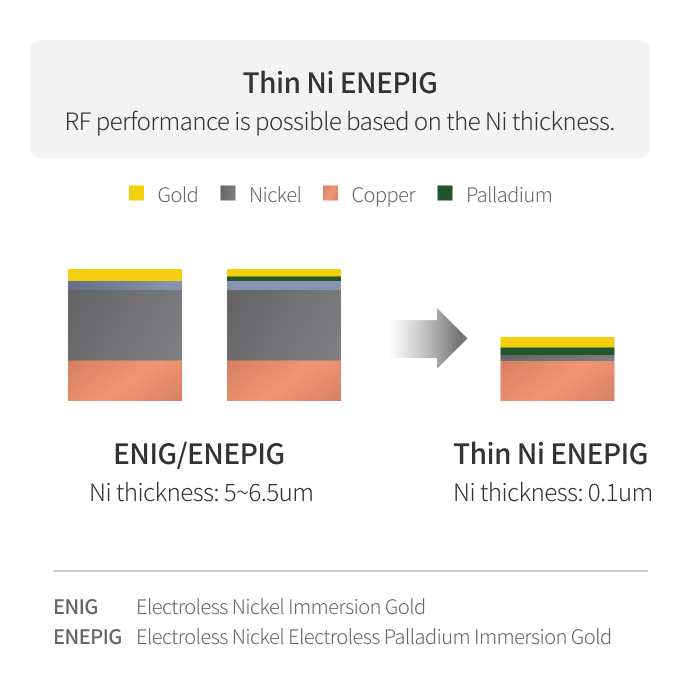
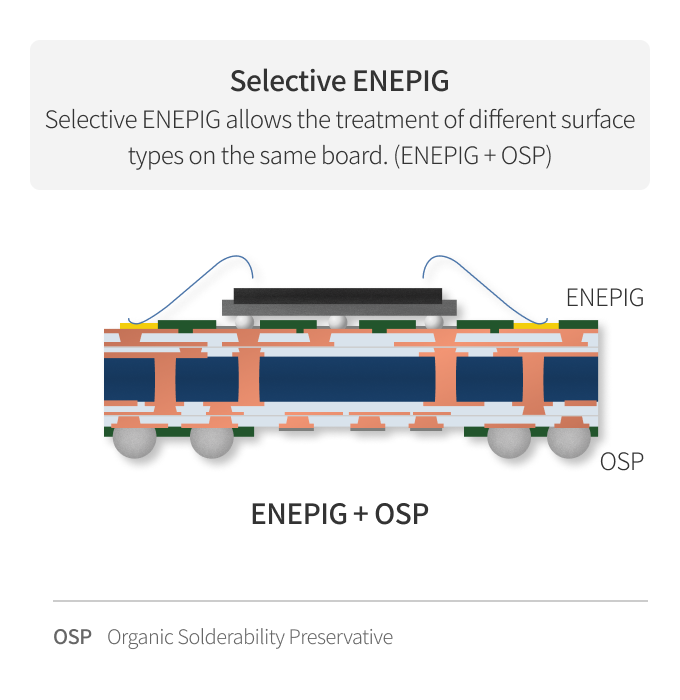
SiP Lineup
Lineup by Specification
| Layer Structure | Cored | 2L / 4L / 6L / 8L / 10L (Mass Production) | + 12L / 14L (Sample Available) |
|---|---|---|---|
| Coreless | 5L / 6L / 7L / 8L (Mass Production) | + 4L / 9L / 10L (Sample Available) | |
| Line Width / Space | 12 / 16um (Mass Production) | 10 / 15um (Sample Available) | |
| Bump Pitch | 130um (Mass Production) | 105um (Sample Available) | |
| Surface Finish | Direct Au, Thin ENEPIG, Selective ENEPIG (Mass Production) | Direct Au, Thin ENEPIG, Selective ENEPIG (Sample Available) | |
* um stands for ㎛