Flip Chip Bonding High-Density Package Substrate for AP/BB, Controllers
It is called a Flip Chip Chip Scale Package (FCCSP) because it is connected to the substrate in an inverted position via bumps rather than via wire bonding to the semiconductor. It is mainly used for high-performance semiconductors such as APs (Application Processors) in mobile IT devices. In addition, compared with WBCSP using gold wires, the process using Flip Chip can be applied to high-density semiconductors because the path of electrical signals is shorter, and a large number of inputs/outputs can be formed.
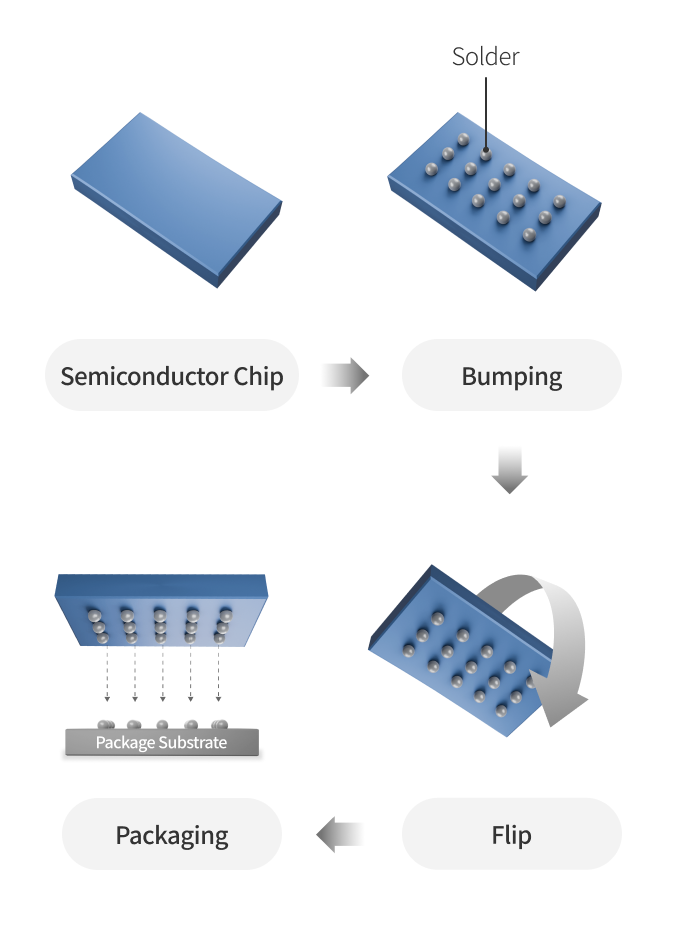
Main Core Technology
Bumping Structure
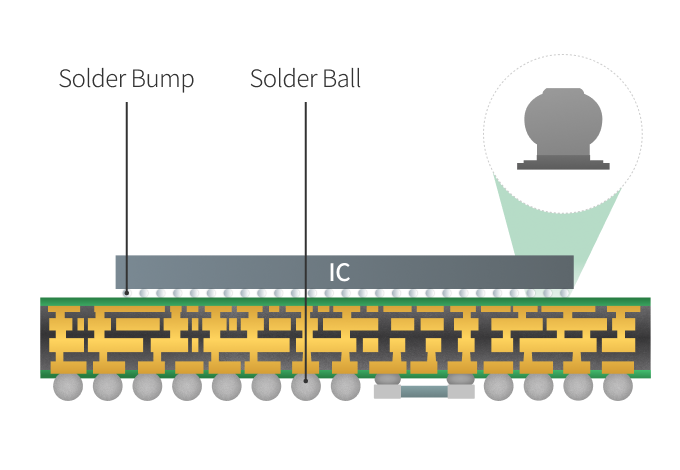
Micro Ball Bump Method
- Available for Fine Bump Pitch
- Good for Small Bump Risk
- Good Quality for Bump Characteristics
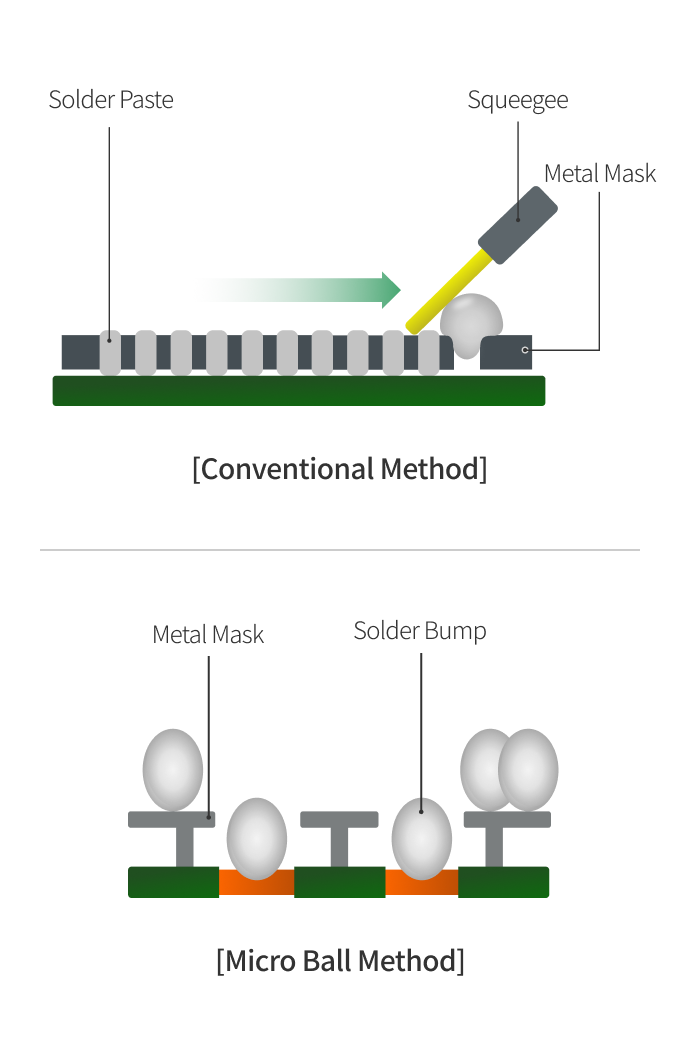
Substrate Type
EPS & EDS (Embedded Passive Substrate & Embedded Die Substrate)
EPS/EDS is a substrate with semiconductor passive components, ICs, etc. embedded within the substrate. Passive components are typically used to stabilize power supply voltage levels. By embedding ICs within the substrate, package size and thickness can be reduced.
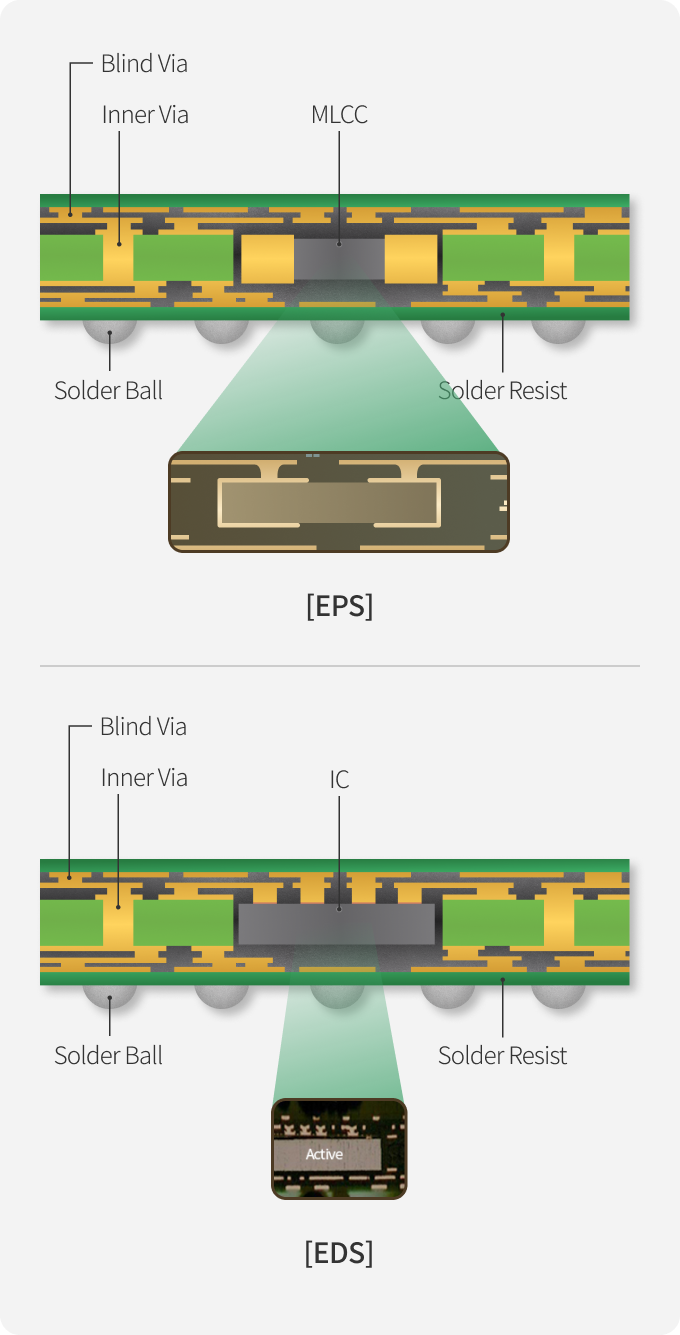
ETS (Embedded Trace Substrate)
ETS is a type of circuit substrate in which the outermost circuit pattern is embedded in insulating material. The substrate has a coreless structure that enables microcircuits to be realized without increasing cost and facilitates layer-down design (4L → 3L). In addition, the etching process does not affect the pattern width, allowing precise control of the circuit width.

FCCSP Lineup
Lineup by Specification
| Routing Density | Build-Up Line Width / Space | 7 / 8um (Mass Production) | 6 / 7um (Sample Available) |
|---|---|---|---|
| BVH / Pad Registration | 40 / 67um (Mass Production) | 37 / 60um (Sample Available) | |
| SRO Diameter SR Registration | 45 ± 10um (Mass Production) | 40 ± 10um (Sample Available) | |
| FC Bump Pitch (Peripheral) | 40um (Mass Production) | 35um (Sample Available) | |
| FC Bump Pitch (Area) | 90um (Mass Production) | 80um (Sample Available) | |
| Low Z-Height | Core / PPG Thickness | 40 / 18um (Mass Production) | 35 / 15um (Sample Available) |
| SR Thickness | 10 ± 4um (Mass Production) | 8 ± 3um (Sample Available) |
* um stands for ㎛